三星直到 12 层垂直堆叠 HBM 产品,一直都在使用热压缩(TC)键合技术。不过随着 HBM 堆叠层数的增加,三星可能会选择改进工艺技术,以适应新一代 HBM 产品的生产需要。三星在之前的一篇采访文章中,再次重申了 HBM4 正在开发当中,将于 2025 年首次亮相。
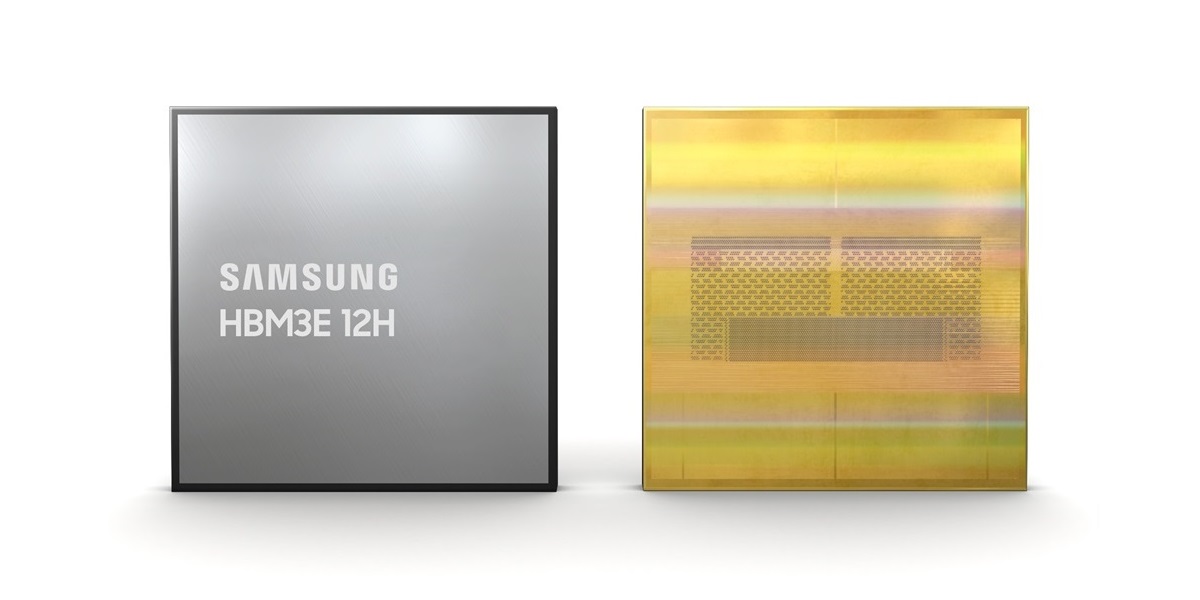
据 The Elec 报道,三星计划生产的 HBM4 里,将分为 12 层及 16 层垂直堆叠两种,其中以 16 层垂直堆叠为主,打算在 2026 年量产。今年 4 月初,三星通过子公司 Semes 的混合键合设备生产了 16 层垂直堆叠的 HBM4 样品,且运行正常。三星认为,对于 16 层垂直堆叠及以上的 HBM 来说,混合键合技术至关重要。
随着堆叠层数的增加,需要缩小芯片之间的间隙,以满足 JEDEC 的规范要求,这非常具有挑战性。传闻 JEDEC 将 12 层及 16 层垂直堆叠的 HBM4 高度限制在 775 微米,这意味着三星需要在这高度内放入 17 块芯片,包括一块基座芯片和 16 块存储芯片。目前三星使用的是 TC NCF 技术,需要高温高压将材料固化再熔化,然后进行清洗。按照目前的情况来看,12 层垂直堆叠里已经逼近极限,引入混合键合技术可以缩小芯片之间的间隙,满足 16 层垂直堆叠 HBM 产品的生产需要。
与三星不同,SK 海力士采用的是 MR-RUF 技术,将半导体芯片附着在电路上,使用 EMC(液态环氧树脂模塑料)填充芯片之间或芯片与凸块之间的间隙。SK 海力士计划 2026 年开始量产 16 层垂直堆叠的 HBM4,目前正在研究采用 MR-MUF 和混合键合技术,但暂时良品率还不高。SK 海力士认为混合键合技术有可能在不超过 775 微米的情况下,实现 20 层以上的堆叠。






